摩尔定律提出至今近60年,平面工艺集成电路,伴随光刻精度的不断提升,晶体管尺寸的微缩逐渐接近硅原子的物理极限。出于制造成本的原因,通过晶体管微缩工艺以实现更高经济价值的逻辑正逐渐变得不再有效。
2015年台积电采用InFO先进封装解决方案,在逻辑工艺并没有升级迭代的情况下,以16nm制程击败三星14nm包揽苹果A10芯片订单,并实现了40%的性能提升,由此我们看到了后摩尔时代的新曙光。先进封装技术具备的优势十分明显,它可以跨越节点生产带来的瓶颈;通过Chiplet形式,利用IP模块化设计新SiP,实现异构整合比SoC更具优势;相比传统IC封测工艺,最新的2.5D/3D-IC、FOWLP封装技术有助于下一代多芯片或异构整合设计所需的电路板设计开发。
然而,晶圆制造一直是我国半导体产业的落后环节,封装技术却是大陆半导体行业中与全球顶尖技术之间差距最小的环节。在国际主流晶圆厂入局先进封装后,封装技术差距也有被进一步拉大的趋势。在此情形下,本土晶圆厂和封测厂如何追赶先进封装工艺,是国内半导体人士的当务之急。
为此,2022年1月21日,由雅时国际商讯主办、大会媒体《半导体芯科技》杂志社协办、CHIP China晶芯在线研讨会承办“第九届晶芯研讨会——新时代先进封装技术发展和应用”,分享了封装制造等一系列问题的解决方案。整场会议高潮迭起、掌声鲜花不断。在这3个多小时的直播时间里,有1037人上线参与,2811次点赞。圆桌论坛环节,四位专家讲师深度剖析,为行业带来一场思想“盛宴”。
讲师精彩回顾
会议当天, ACT雅时国际商讯副总经理&半导体芯科技杂志社负责人 程丽娜作为会议主持人,AcconSys奥肯思(北京)科技有限公司 SiP技术专家 李扬、北京北方华创微电子装备有限公司 先进封装&功率器件业务发展部 总经理 吴文英、胜科纳米(苏州)股份有限公司 副总裁 华佑南、厦门云天半导体科技有限公司 董事长 于大全,针对器件模块尺寸微缩、高良率通孔制作、平衡芯片与封装工艺良率的达成等等话题,为大家带来了精彩分享。
会议开始,首先由ACT雅时商讯总裁、《半导体芯科技》出版总监麦协林先生带来致辞,在线听众朋友们热情高涨,纷纷点赞!
第一位演讲嘉宾,AcconSys(北京)科技公司 SiP技术专家李扬老师,为我们分享了《2.5D/3D 先进封装技术——设计和分析挑战》主题报告。
Acconsys(北京)科技有限公司是国内领先的电子电气设计自动化和管理信息化方案与服务提供商。李扬老师参与和指导国内各类SiP项目超过40多项,曾在中国科学院国家空间中心、SIEMENS工作,参与中国载人航天“神舟”系列飞船及中欧合作“双星”等项目。目前负责微系统产品研发,SiP及IC封装设计技术支持和项目指导工作。
李扬老师认为,2.5D和3D是先进封装中的热点技术,其设计、仿真和验证方法也和传统的IC封装有较大的差异,因此也成为芯片、封装和系统设计人员关注的焦点。演讲主要阐述了2.5D和3D先进封装的概念、设计要求和设计方法,并通过实例阐述了在EDA工具中如何进行2.5D和3D先进封装的设计、仿真和验证。
第二位演讲嘉宾,北方华创微电子装备有限公司 先进封装&功率器件业务发展部 总经理 吴文英,为我们分享了《2.5D/3D TSV以及高密度Fan-out装备和工艺解决方案》主题报告。
北方华创微电子装备有限公司是国内集成电路高端工艺装备的领先企业,拥有半导体装备、真空装备、新能源锂电装备及精密电子元器件四个事业群,为半导体、新能源、新材料等领域提供解决方案。在集成电路制造领域,北方华创是国内最具竞争力的前道硅刻蚀机、PVD、立式炉、清洗机产品的供应商,技术水平处于国内领先地位。
随着先进封装互连技术的演变,由点到面,再到三维堆叠,密度越来越高。2.5D/3D TSV以及Fan-out WLP由于其灵活、高密度、适于系统集成,成为目前先进封装的主流热点技术。干法刻蚀、PVD、ALD、热处理炉管等越来越多被引入,前、中道工艺渗透不断加深。
TSV技术通过铜、钨、多晶硅等导电物质的填充,实现硅通孔的垂直电气互连。TSV可以通过垂直互连减小互联长度,减小信号延迟,降低电容/电感,实现芯片间的低功耗,高速通讯,增加宽带和实现器件集成的小型化。TSV工艺主要包括深硅刻蚀形成微孔,绝缘层/阻挡层/种子层的沉积,深孔填充,化学机械抛光,减薄、pad的制备及再分布线制备等工艺技术。吴文英总经理为我们分享了北方华创2.5D/3D TSV高密度互连装备及工艺解决方案。另外,Wafer level Fan-out面临更大的晶圆翘曲、更苛刻的温度控制等挑战,如何在工艺过程中实现高效稳定的传输、更优异的接触电阻,在量产中也非常关键。北方华创为我们提供了高密度Fan-out WLP装备及工艺解决方案。
第三位演讲嘉宾,胜科纳米(苏州)股份公司 华佑南副总裁,为我们分享了《失效分析技术在半导体先进封装良率提升中的应用》主题报告。
胜科纳米作为知名的第三方分析实验室,专业的半导体芯片的分析测试和辅助研发中心。提供一站式失效分析、材料分析、可靠性分析等服务。拥有国内唯一完整的7nm/5nm芯片失效分析线。2020年首创Labless模式,打造“芯片全科医院”。
华佑南博士认为,当前半导体芯片制造的积点越来越小,已经达到了7纳米和5纳米,甚至3纳米,制程积点已逐渐接近极限。那么先进封装技术可将多个不同功能、尺寸各异、不同工艺积点的芯片堆叠起来,可以把容量扩大到传统芯片的很多倍,也可将各种类型的芯片组合起来,通过先进封装形成一个系统。那么在半导体晶圆制造和先进封装中,如何平衡芯片与封装制造环节使之产品良率达到统一,又如何提升良率是极其重要的。
华佑南博士通过5个应用案例:
✔铝焊盘不能被键合(NSOP);
✔3D堆叠封装失效定位;
✔2D X-Ray检测分析案例/ 3D X-Ray CT检测分析;
✔背散射电子衍射分析技术(EBSD);
✔中空TSV样品制备;
详细讲解了“失效分析在半导体先进封装良率提升中的应用”。另外,胜科纳米提出的检测方法——OSAT技术,可快速高效地为晶圆制造厂、封测厂等提供一个控制铝焊盘质量的可靠监测方案。
第四位演讲嘉宾是,厦门云天半导体科技有限公司 于大全董事长。于大全董事长是《半导体芯科技》杂志社的编委老师,发表学术论文200多篇,授权发明专利60多项。于老师同时也是2020年度“国家科学技术进步一等奖”的获得者,这个奖项是国家对科技创新的最高褒奖,它是对过去二十年我国封测技术突飞猛进、部分技术赶超国际先进水平的高度认可。今天为我们分享了《射频器件的先进封装技术发展趋势》主题报告。
厦门云天半导体科技有限公司自成立以来,一直致力于5G射频器件封装集成技术,主要业务包含滤波器晶圆级三维封装,高频毫米波芯片集成,射频模块集成,IPD无源器件设计与制造,以及Bumping/WLCSP/TGV技术,公司具备从4寸、6寸到8寸、12寸全系列晶圆级封装能力。产品广泛应用于智能手机等移动终端、自动驾驶、卫星通讯和光通讯等重要领域。公司抓住5G时代机遇,成为国际顶尖的半导体先进系统集成创新企业。
于大全老师认为,摩尔定律发展趋缓,先进封装越来越成为延续和拓展摩尔定律的重要手段;其中,硅通孔、扇出型封装、三维IC堆叠以及异质集成技术发展迅速,并在先进系统集成产品应用中占据核心地位。射频前端模块是5G通讯核心,市场需求量巨大,对射频器件和模块小型化的需求迫切。
在集成电路应用的多元化发展趋势下,满足系统微型化、多功能化的先进封装技术成为产业发展的新的引擎。于大全老师论述了射频市场需求及现状,分析射频器件先进封装的演变以及当下面临的挑战以及最新的技术发展趋势。
互动问答
直播间内听众们纷纷提出了他们对于“新时代先进封装技术发展和应用”等一系列问题,部分未回答的问题,经四位专家答疑后,集中反馈将在后续公众号、社群内推出,敬请期待。
好记性不如烂笔头,各位听众朋友们听完会议后想再次加强学习,请关注社群消息或私信客服号,经讲师确认后,工作人员会在《 半导体芯科技 SiSC》公众号内设置关键词:01.21演讲资料,即可获取本次会议部分讲师演讲资料哦~
圆桌论坛
我国芯片业迎来黄金发展期,业界在期盼弯道超车、换道超车,但这需要技术和技巧。本次会议的圆桌论坛中就“如何有效提高我国封装技术水平,推动产业化应用?”展开激烈讨论,业界四位专家分享了各自的专业观点,围绕“应用在国内,2.5D/3D高端封装目前是台积电在引领,国内企业如何改变高端技术滞后问题”、“如何更有效地组织产业合作?”、“5G作为我国新基础建设的重点,先进封装如何把握历史机遇?”这4个话题内容线上共话,带来独到见解。
本次圆桌论坛由于大全老师担任主持,与三位业内专家进行深度研讨。那么如何有效提高我国封装技术水平,吴文英总经理表示,从装备角度来看,晶圆级封装具体到装备这块,应该是和国际装备环节差距相对较小的。本土装备厂商已有一定的基础,我们要对新技术要有一个敏感性和前瞻性,同时产业化上下游需要鼎力配合来达到量产。此外华佑南博士认为台积电从产值是在引领,在技术上美国还是领先,现在我们如何解决滞后的问题,要重视人才资源互相取长补短,以及认识差距努力赶上,就要有先进的晶圆制造作为基础,把封装跟上去,挑战摩尔定律,强强联合促进合作。
5G作为我国新基础建设的重点,先进封装如何把握历史机遇?于大全老师提出此提问来展开讨论,华佑南博士发表观点,抓住机遇,追赶技术的时候也要重视培养人才,这是一个长期战。胜科纳米已经走出第一步抓住人才培养,并且有能力也有信心助力国内半导体产业发展。李扬老师认为,高频仿真实际上不用整体分析,针对局部就可以。5G对高密度、高精度并不高,对多样化、灵活化要求会比较高。
听完四位专家圆桌论坛的深入研讨
有哪些观点让您印象深刻?
期待下次会议讨论哪些半导体行业相关话题?
欢迎留言分享!
幸运抽奖,祝福到家
历时3个多小时圆满落幕的第九届CHIP China晶芯在线研讨会上,林**、任**、陶**、朱**、华**等幸运听众在本次会议的抽奖环节中获得我社准备的相关奖品!
叮咚,2022年,您的第一份新年礼物正在快马加鞭的邮寄啦!值此虎年春节来临之际,半导体芯科技全体工作人员真诚地将这份祝福送达至各位听众的手中,感谢听众朋友们长久以来的支持和关注。
2022年,我们将陆续举办接下来的10场主题线上研讨会及线下峰会,为各位听众朋友们解析先进封装、MEMS、车规级芯片测试与可靠性、半导体测试与测量、芯片设计、工艺缺陷分析等精彩内容,洞悉半导体行业趋势,了解最新动态。期待您的持续关注,提前祝大家新年快乐,虎力全开,福虎生威,虎运亨通!
审核编辑:汤梓红
 电子发烧友App
电子发烧友App




























































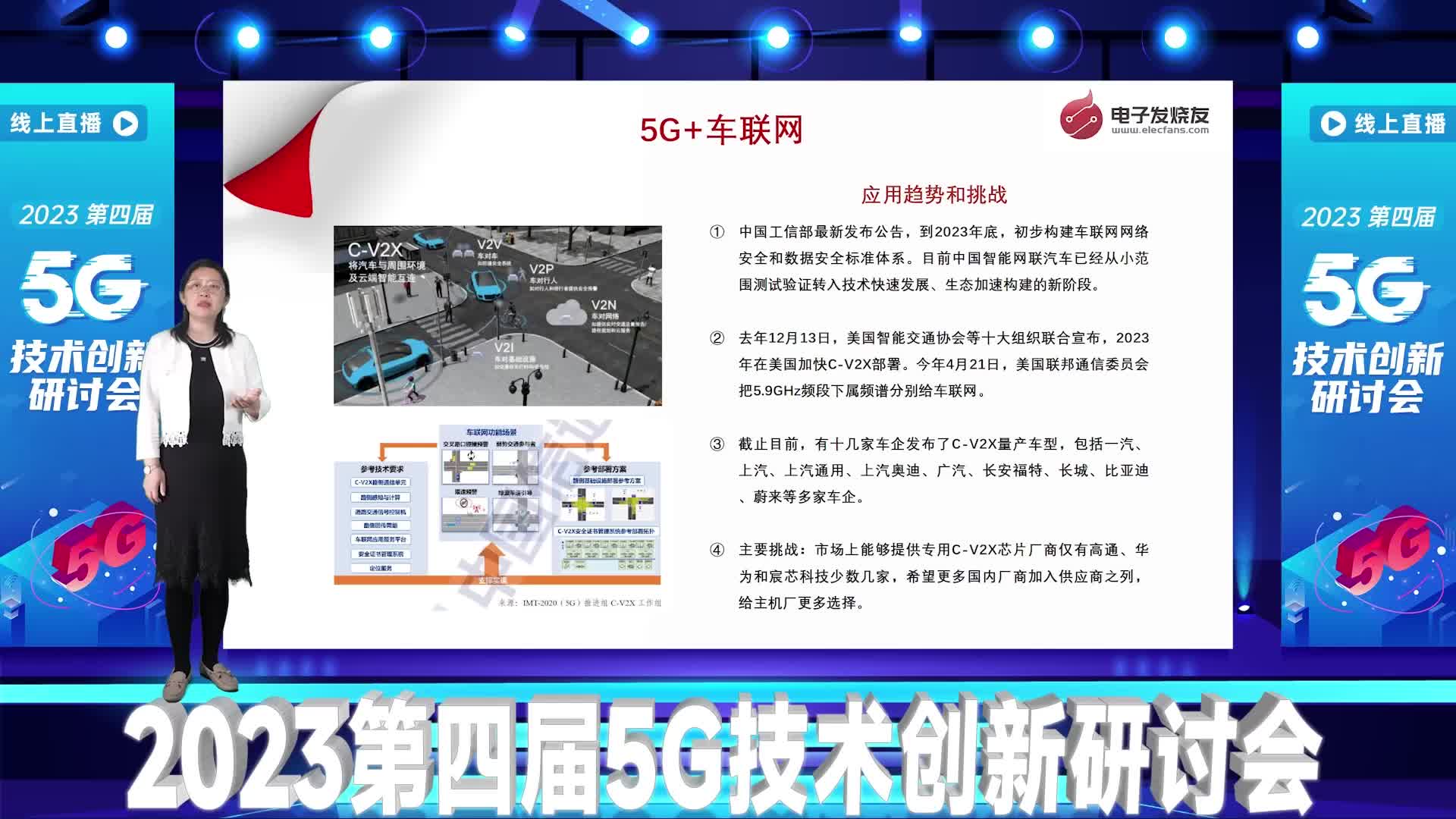






















评论